欢迎来到东莞市朗孚光电科技有限公司官网!

在线留言
收藏本站

网站地图
欢迎来到东莞市朗孚光电科技有限公司官网!
在线留言
收藏本站

网站地图


LED灯珠是LED应用的最基本的形态,LED封装的各种技术,方法,流程,设备,和封装的外形,直接关系到后续下游LED的应用方式和应用的范围,往往LED的封装技术的革新,都会使得LED行业带来深刻的变化。
下面分别从,流程,方式,设备和外形尺寸来初步讲解一下。
一,LED封装技术
其实这是一个比较泛的论题,它可包含多方面的关于LED封装方面的知识,这里只是粗略讲一下相关的。
LED封装技术的基本内容和追求的目标:提高出光效率、高光色性能及器件可靠性。
提高出光效率:
LED封装的出光效率一般可达80~90%。
①选用透明度更好的封装材料:透明度≥95%(1mm厚度),折射率大于1.5等。
②选用高激发效率、高显性的荧光粉,颗粒大小适当。
③装片基板(反射杯)要有高反射率,出光率高的光学设计外形。
④选用合适的封装工艺,特别是涂覆工艺。
高光色性能:
LED主要的光色技术参数有:高度、眩光、色温、显色性、色容差、光闪烁等。
显色指数CRI≥70(室外)、≥80(室外)、≥90(美术馆等)。
色容差≤3 SDCM≤5 SDCM(全寿命期间)
封装上要采用多基色组合来实现,重点改善LED辐射的光谱量分布SPD,向太阳光的光谱量分布靠近。要重视量子点荧光粉的开发和应用,来实现更好的光色质量。
器件可靠性:
LED可靠性包含在不同条件下LED器件性能变化及各种失效模式机理(LED封装材料退化、综合应力的影响等),这是主要提到可靠性的表征值—寿命,目前LED器件寿命一般为3~5小时,可达5~10万小时。
①选用合适的封装材料:结合力要大、应力小、匹配好、气密性好、耐温、耐湿(低吸水性)、抗紫外光等。
②封装散热材料:高导热率和高导电率的基板,高导热率、高导电率和高强度的固晶材料,应力要小。
③合适的封装工艺:装片、压焊、封装等结合力强,应力要小,结合要匹配。
网上这个资源,对LED封装方面的知识较全面,大家有时间可去看看。LED封装技术-中国LED在线
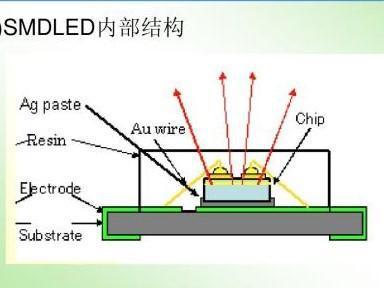
结构剖图
二,LED封装工艺流程
LED封装,概括来说就是将外引线连接到LED芯片的电极上,同时保护好LED芯片,并且起到提高光取出效率的作用。关键工序有装架、压焊、封装。
工艺流程如下:
1、芯片检验
镜检:材料表面是否有机械损伤及麻点麻坑
芯片尺寸及电极大小是否符合工艺要求;电极图案是否完整
2、扩片
由于LED芯片在划片后依然排列紧密间距很小,不利于后工序的操作。我们采用扩片机对黏结芯片的膜进行扩张,是LED芯片的间距拉伸到约0.6mm.也可以采用手工扩张,但很容易造成芯片掉落浪费等不良问题。
3、点胶
在LED支架的相应位置点上银胶或绝缘胶。工艺难点在于点胶量的控制,在胶体高度、点胶位置均有详细的工艺要求。由于银胶和绝缘胶在贮存和使用均有严格的要求,银胶的醒料、搅拌、使用时间都是工艺上必须注意的事项。
4、备胶
和点胶相反,备胶是用备胶机先把银胶涂在LED背面电极上,然后把背部带银胶的LED安装在LED支架上。备胶的效率远高于点胶,但不是所有产品均适用备胶工艺。
5、手工刺片
将扩张后LED芯片安置在刺片台的夹具上,LED支架放在夹具底下,在显微镜下用针将LED芯片一个一个刺到相应的位置上。手工刺片和自动装架相比有一个好处,便于随时更换不同的芯片,适用于需要安装多种芯片的产品。
6、自动装架
自动装架其实是结合了沾胶和安装芯片两大步骤,先在LED支架上点上银胶,然后用真空吸嘴将LED芯片吸起移动位置,再安置在相应的支架位置上。自动装架在工艺上主要要熟悉设备操作编程,同时对设备的沾胶及安装精度进行调整。在吸嘴的选用上尽量选用胶木吸嘴,防止对LED芯片表面的损伤,特别是兰、绿色芯片必须用胶木的。因为钢嘴会划伤芯片表面的电流扩散层。
7、烧结
烧结的目的是使银胶固化,烧结要求对温度进行监控,防止批次性不良。银胶烧结的温度一般控制在150℃,烧结时间2小时。根据实际情况可以调整到170℃,1小时。绝缘胶一般150℃,1小时。
银胶烧结烘箱的必须按工艺要求隔2小时打开更换烧结的产品,中间不得随意打开。烧结烘箱不得再其他用途,防止污染。
8、压焊
压焊的目的将电极引到LED芯片上,完成产品内外引线的连接工作。LED的压焊工艺有金丝球焊和铝丝压焊两种。右图是铝丝压焊的过程,先在LED芯片电极上压上第一点,再将铝丝拉到相应的支架上方,压上第二点后扯断铝丝。金丝球焊过程则在压第一点前先烧个球,其余过程类似。压焊是LED封装技术中的关键环节,工艺上主要需要监控的是压焊金丝拱丝形状,焊点形状,拉力。对压焊工艺的深入研究涉及到多方面的问题,如金丝材料、超声功率、压焊压力、劈刀选用、劈刀运动轨迹等等。
9、点胶封装
LED的封装主要有点胶、灌封、模压三种。基本上工艺控制的难点是气泡、多缺料、黑点。设计上主要是对材料的选型,选用结合良好的环氧和支架。一般情况下TOP-LED和Side-LED适用点胶封装。手动点胶封装对操作水平要求很高,主要难点是对点胶量的控制,因为环氧在使用过程中会变稠。白光LED的点胶还存在荧光粉沉淀导致出光色差的问题。
10、灌胶封装
Lamp-LED的封装采用灌封的形式。灌封的过程是先在LED成型模腔内注入液态环氧,然后插入压焊好的LED支架,放入烘箱让环氧固化后,将LED从模腔中脱出即成型。
11、模压封装
将压焊好的LED支架放入模具中,将上下两副模具用液压机合模并抽真空,将固态环氧放入注胶道的入口加热用液压顶杆压入模具胶道中,环氧顺着胶道进入各个LED成型槽中并固化。
12、固化与后固化
固化是指封装环氧的固化,一般环氧固化条件在135℃,1小时。模压封装一般在150℃,4分钟。
13、后固化
后固化是为了让环氧充分固化,同时对LED进行热老化。后固化对于提高环氧与支架的粘接强度非常重要。一般条件为120℃,4小时。
14、切筋和划片
由于LED在生产中是连在一起的,Lamp封装LED采用切筋切断LED支架的连筋。SMD-LED则是在一片PCB板上,需要划片机来完成分离工作。
15、测试
测试LED的光电参数、检验外形尺寸,同时根据客户要求对LED产品进行分选。
16、包装
将成品进行计数包装。超高亮LED需要防静电包装。

LED封装步骤
三,LED封装方式,结构
LED光集成封装结构现有30多种类型,正逐步走向系统集成封装,是未来封装技术的发展方向。
(1)COB集成封装
COB集成封装现有MCOB、COMB、MOFB、MLCOB等30多种封装结构形式,COB封装技术日趋成熟,其优点是成本低。COB封装现占LED光源约40%左右市场,光效达160~178 lm/w,热阻可达2℃/w,COB封装是近期LED封装发展的趋势。

(2)晶圆级封装
晶圆级封装从外延做成LED器件只要一次划片,是LED照明光源需求的多系统集成封装形式,一般衬底采用硅材料,无需固晶和压焊,并点胶成型,形成系统集成封装,其优点是可靠性好、成本低,是封装技术发展方向之一。
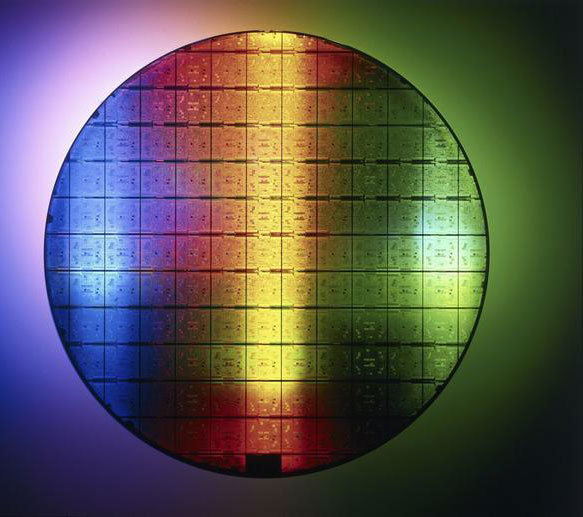
(3)COF集成封装
COF集成封装是在柔性基板上大面积组装中功率LED芯片,它具有高导热、薄层柔性、成本低、出光均匀、高光效、可弯曲的面光源等优点,可提供线光源、面光源和三维光源的各种LED产品,也可满足LED现代照明、个性化照明要求,也可作为通用型的封装组件,市场前景看好。
(4)LED模块化集成封装
模块化集成封装一般指将LED芯片、驱动电源、控制部分(含IP地址)、零件等进行系统集成封装,统称为LED模块,具有节约材料、降低成本、可进行标准化生产、维护方便等很多优点,是LED封装技术发展的方向。
(5)覆晶封装技术
覆晶封装技术是由芯片、衬底、凸块形成了一个空间,这样封装出来的芯片具有体积小、性能高、连线短等优点,采用陶瓷基板、覆晶芯片、共晶工艺、直接压合等来达到高功率照明性能要求。
用金锡合金将芯片压合在基板上,替代以往的银胶工艺,“直接压合”替代过去“回流焊”,具有优良的导电效果和导热面积。该封装技术是大功率LED封装的重要发展趋势。
(6)免封装芯片技术
免封装技术是一个技术的整合,采用倒装芯片,不用固晶胶、金线和支架是半导体封装技术70种工艺形成中的一种。
PFC免封装芯片产品的光效可提升至200lm/w,发光角度大于300度的超广角全周光设计,不要使用二次光学透镜,将减少光效的耗损与降低成本,但要投入昂贵的设备。
PFC新产品主打LED照明市场,特别是应用在蜡烛灯上,不仅可以模拟钨丝灯的造型,同时可以突破散热体积的限制。
(7)LED其他封装结构形式
①EMC封装结构:是嵌入式集成封装形式(Embedded LED Chip)不会直接看到LED光源。
②EMC封装技术:(Epoxy Molding Compound)以环氧塑封料为支架的封装技术,具有高耐热、高集成度、抗UV、体积小等优点,但气密性差些,现已批量生产。
③COG封装:(Chip On Glass)将LED芯片放在玻璃基板上进行封装。
④QFN封装技术:小间距显示屏象素单元小于或等于P.1时,所采用的封装形式,将替代PLCC结构,市场前景看好。
⑤3D封装技术:以三维立体形式进行封装的技术,正在研发中。
⑥功率框架封装技术:(Chip-in-Frame Package)在小框架上封装功率LED芯片,产业化光效已达160~170 lm/w,可达200 lm/w以上。
四,LED封装尺寸(形状)
分为表贴式(SMD)和直插式(DIP),表贴就是大家常说的贴片,也成为贴片式,本文主要介绍贴片灯珠的规格尺寸和命名。
单颗LED封装后通常以其尺寸命名,比如: 3528、5050、0603、0805、3020、335、020、3535、3014等,这些简称也就成为具体的规格型号,但需要注意的是:有的是英制的,有的是公制的,单位并不完全统一。
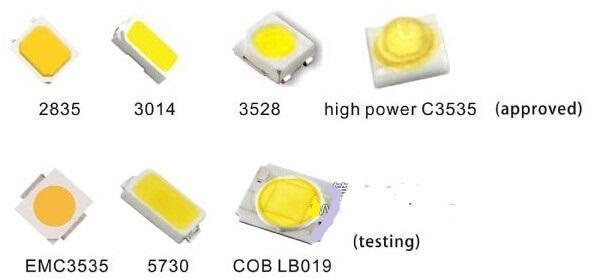
注:1 英寸 = 2.539999918 厘米(公分),通常的取法是:1inch = 25.4 mm
结合上表做一些简单的说明,举例说明LED贴片常见的规格型号及其含义:2835、3535、3030、3528,5050是指表贴型 SMD LED的尺寸大小,也就是对应的规格。
例如:3528:这是公制叫法,即表封装后LED元件的长度是3.5mm,宽度是2.8mm。行业简称3528。
5050:这是公制叫法,即表封装后LED元件的长度是5.0mm,宽度是5.0mm。行业简称5050。

